
CAEソフト【 Femtet 】-ムラタソフトウェア株式会社

IC実装工程の多段階熱荷重解析
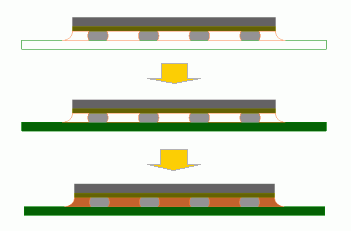
本例題について
-
はんだバンプを有するICの実装工程ではまずICが基板へ実装され、そのあとアンダーフィルが塗布され硬化する
という流れが一般的ですが、はんだの硬化温度とアンダーフィルの硬化温度が異なるため、通常の熱荷重解析
では最終状態や最終状態から温度変化した場合の熱応力解析を行うことができません。 -
多段階熱荷重解析では到達温度を複数ステップ設定し、かつ途中のステップからボディを解析
対象とすることができます。 -
同じモデルで、はんだの弾塑性/クリープを考慮し、IC稼働時の発熱による応力解析を行った例題を熱応力連成解析の
例題8 IC実装工程+IC稼働時の応力解析で紹介しています。 -
各到達温度における変位分布や応力分布を解析結果として見ることができます。
-
表に記載されていない条件は初期設定の条件を使用します。
解析空間
|
項目 |
条件 |
|
解析空間 |
2次元 |
|
モデル単位 |
mm |
解析条件
本例題では簡易的な2次元解析モデルを扱います。
熱荷重の解析オプションを選択します。
|
項目 |
条件 |
|
ソルバ |
応力解析[Galileo] |
|
解析の種類 |
静解析 |
|
解析オプション |
熱荷重をチェック |
本例題では以下のような工程を想定します。
ステップ1.基板とIC間をはんだ付け(220度)したあと常温(25度)まで落とす。
ステップ2.常温(25度)から120度まで温度を上げる。
ステップ3.120度でアンダーフィルを塗布して硬化させたあと常温(25度)まで落とす。
ステップ4.常温(25度)から85度まで温度を上げる。
ステップ/熱荷重タブの設定を以下のように行っています。
多段階熱荷重設定の詳細設定として温度プロファイル表を以下のように設定しています。
|
タブ設定 |
設定項目 |
条件 |
||||||||||||||
|
ステップ/熱荷重 |
ステップ設定 |
多段階熱荷重解析 |
||||||||||||||
|
基準温度 |
220[deg] |
|||||||||||||||
|
ステップ/到達温度設定 |
|
後述しますが、ステップ3以降にアンダーフィルを解析対象とするための設定をボディ属性の解析領域タブにて行っています。
|
|
モデル図
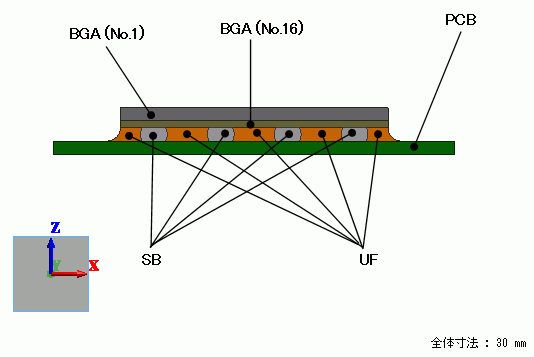
ボディ属性および材料の設定
|
ボディ No./ボディタイプ |
ボディ属性名 |
材料名 |
|
0/Sheet |
PCB |
GLASS_EPOXY |
|
1/Sheet |
BGA |
EPOXY |
|
3/Sheet |
SB |
SOLDER |
|
4/Sheet |
SB |
SOLDER |
|
5/Sheet |
SB |
SOLDER |
|
6/Sheet |
SB |
SOLDER |
|
11/Sheet |
UF |
UNDER_FILL |
|
12/Sheet |
UF |
UNDER_FILL |
|
13/Sheet |
UF |
UNDER_FILL |
|
14/Sheet |
UF |
UNDER_FILL |
|
15/Sheet |
UF |
UNDER_FILL |
|
16/Sheet |
BGA |
GLASS_EPOXY |
材料定数は以下のように設定しています。
|
材料名 |
タブ |
定数 |
|||||
|
GLASS_EPOXY |
弾性定数 |
ヤング率: 28×109[Pa] ポアソン比: 0.3 |
|||||
|
線膨張係数 |
異方性: 異方をチェック 線膨張係数ベクトル:
|
||||||
|
EPOXY |
弾性定数 |
ヤング率: 19×109[Pa] ポアソン比: 0.3 |
|||||
|
線膨張係数 |
11×10-6[1/deg] |
||||||
|
SOLDER |
弾性定数 |
ヤング率: 31×109[Pa] ポアソン比: 0.4 |
|||||
|
線膨張係数 |
21×10-6[1/deg] |
||||||
|
UNDER_FILL |
弾性定数 |
ヤング率: 3.5×109[Pa] ポアソン比: 0.3 |
|||||
|
線膨張係数 |
90×10-6[1/deg] |
UFはステップ3以降に有効にするため解析領域タブにて以下のように設定しています。
|
ボディ属性名 |
タブ |
設定 |
|
UF |
解析領域 |
バース/デス設定: ステップ1:× |
境界条件
なし
解析結果
各ステップの到達温度における応力ベクトル図を示します。
ベクトルのスケールを統一するためゴッホ設定としてベクトルタブの最小値/最大値設定を0⇒200Mとしています。
ステップ1: 到達温度25度:
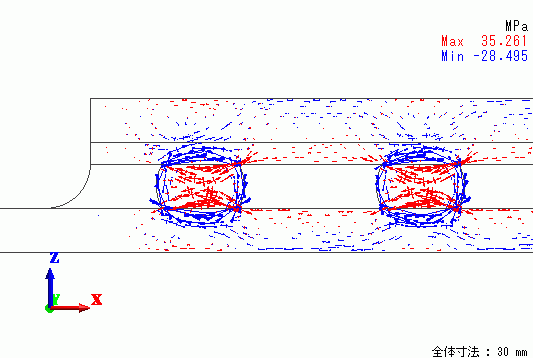
ステップ2: 到達温度120度:
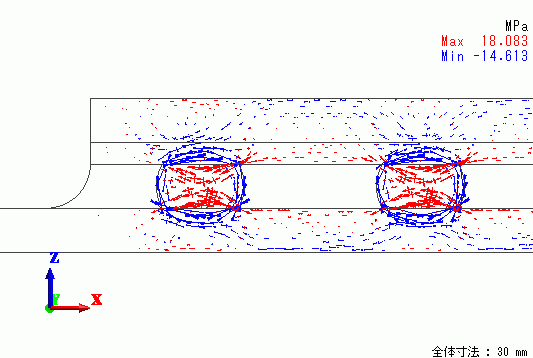
ステップ3: 到達温度25度:
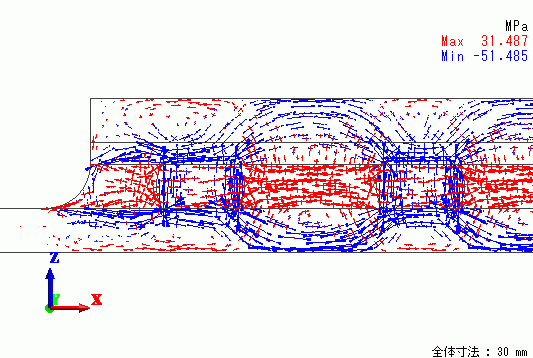
ステップ4: 到達温度85度:
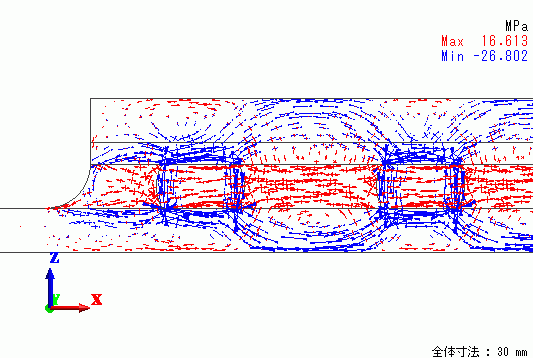
これらの結果よりアンダーフィル有無に関わらず、硬化温度に対して環境温度が離れるほど内部応力が増加する傾向が
あることが分かります。また、ステップ1とステップ3の結果を比較するとアンダーフィルの収縮によってICやPCB内部の応力が
増加していることが分かります。
まずはFemtetを試してみたい
試用版はこちらもっとFemtetについて詳しく知りたい
イベント・セミナー情報はこちら